2.1 聯柵是什么
2018年杭州優捷敏半導體技術有限公司提出一種新型功率器件——聯柵晶閘管,英文名稱Gate Associated Thyristors,簡稱GATH。
聯柵的“柵”是交叉柵,跟發射極金屬層正交的濃基區。
聯柵把功率管分割成許許多多的細小元胞。比原來的BJT和GTO的元胞多10--100倍,元胞的周邊總長度增加10-100倍,周邊的電流密度降低了1-2個數量級,電流集邊效應減弱了1-2個數量級。從而解決了電流型功率器件的主要問題——BJT的二次擊穿、GTO的dI/dt和dV/dt限制。

圖2-1 GATH圖像
2.2 GATH對功率器件的改進2.2.1 GATH的結構
GATH是一種特殊的SITH/BJT,即采用多晶硅發射極的靜電感應晶閘管與雙極晶體管的復合功率管。其特點是濃柵代鋁,元包細微。圖2-2是GATH的結構示意圖,藍色的一層是多晶硅發射極,P+濃摻雜柵區的上面沒有鋁層,柵區匯流條上面才有鋁層,如圖2-3所示。

圖2-2 GATH結構示意圖 圖2-3 GATH電子顯微鏡照片
(1)寬的長條是由許多長方形的元胞組成的條帶,上面連接發射極金屬層
(2)窄的長條是濃基區(柵區)匯流條,上面連接柵極(基極)金屬層
2.2.2 GATH的工作原理
GATH的工作原理可以看作是一種IGCT。
GATH的柵區上面沒有鋁層,因此,元包能夠做得很小,只有IGCT的千分之一。
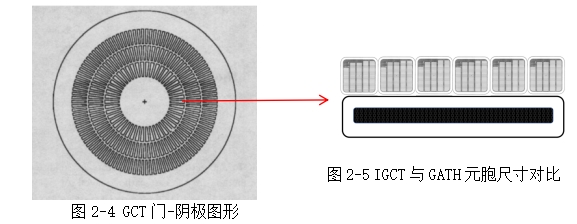
圖2-4是IGCT的圖像,圖3-5是IGCT圖像與GATH圖像尺寸對比。IGCT的一個元包就是一個臺面加周邊,其尺寸大小相當于GATH的有源區X方向排列6個。
2.2.3. GATH改進元胞變小解決了什么問題
(1)降低IGCT的開關功耗,驅動簡單,成本降低
GATH的元包細小,容易開關。其關斷驅動功耗僅為IGCT的10%,而且能夠安全關斷GATH十倍的電流。
(2)關斷電流大于IGCT

圖2-6 GATH的關斷波形照片
圖2-6是GATH 1200V 20A的關斷波形照片。從中能夠看到,電流峰值50A,功率管的殼溫200°C。該功率管的有源區面積是2mm*2mm,GATH的關斷電流密度達到1200A/cm2,遠遠高于IGCT的80A/cm2。
(3)抗雪崩能力超過IGBT
IGBT的主要失效模式是過電壓雪崩引發閂鎖。圖2-7顯示,IGBT元包內部有PNPN四層結構,雪崩電流超過臨界值,就必定觸發晶閘管發生閂鎖。
GATH不會雪崩引發閂鎖。圖2-8顯示,GATH的柵區P+與元包內部連接,雪崩電流被P+統統抽走,不經過PNPN四層結構,不觸發晶閘管,所以,不會閂鎖。

圖2-7 IGBT內部NPNNP結構導致閂鎖 圖2-8 GATH深柵P+結構
2.3 逆導型GATH
GATH適合硬開關的高壓大功率逆導型。GATH沒有閂鎖問題,魯棒性強,能夠做成適用于硬開關的高壓大功率逆導型產品。
逆導型,為了解決電流折拐,必定造成橫向電場不均勻,從而加重了IGBT的閂鎖。因此,IGBT不適合做高壓大功率硬開關的逆導型。
根據ABB的規格書,RCIGCT只能夠工作在零度以上,不能夠在零度以下工作。IGCT因為元包太大,開通必須兩次,才能夠充分開通,低溫環境更難充分開通。而逆導型RCIGCT,集成的二極管能把一部分開通驅動電流拉走。使得開通電流更小,零度以下,即使開通兩次,也不能充分開通。所以,逆導型RCIGCT不能在零度以下工作。
RCGATH元包細微,驅動內阻小,零度以下,也能夠造成開通。
2.4 聯柵的技術來源
聯柵技術來源于幾個方面:獨創的深柵P+替代柵鋁、傳統的聯柵晶體管GAT、IGCT和FS IGBT、超高速雙極型IC。
2.4.1獨創的深柵P+替代柵鋁
聯柵技術采用獨創的深柵P+替代柵鋁,即柵區上面沒有鋁,只在柵區匯流條上面布鋁,元包縮小到~10µm(碳化硅基聯柵功率管~3µm)。從而獲得了高可靠。
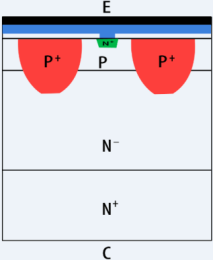
圖2-9聯柵結構示意圖
聯柵結構五個基本特征:
(1)發射極金屬層下面是摻雜多晶硅,摻雜多晶硅下面連接發射區,發射區下面是基區和柵區(濃基區)
(2)柵區與發射極金屬層正交
(3)柵區上面不連接柵極金屬層
(4)柵區從側下面引出到柵區匯流條再連接柵極金屬層
(5)元胞13μm
2.4.2傳統聯柵晶體管GAT
傳統GAT是一種SIT/BJT的復合型功率器件,在BJT的兩側設有深柵P+的低阻通道,有利于提高開關速度,并增強可靠性。
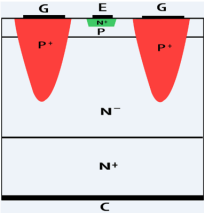
圖2-10 傳統GAT管結構示意圖
2.4.3 IGCT和FS IGBT
IGCT和FS IGBT的FS緩沖層和透明陽極(IGBT叫做透明
集電極),能夠降低導通電阻、提高關斷速度。聯柵晶閘管GATH吸收采用了這兩項技術。
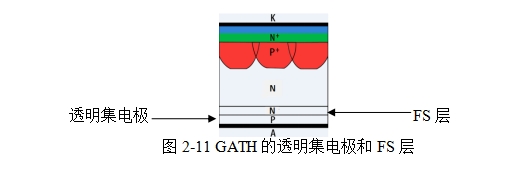
圖2-11 GATH的透明集電極和FS層
2.4.4超高速雙極型IC
聯柵功率管采用了超高速雙極IC的多晶硅發射極技術,增大了復合,減小了關斷瞬間的電流拖尾,獲得了高速度。

圖2-12 GATH的多晶硅發射極
多晶硅發射極來源于雙極型超高速IC的技術。多晶硅發射極超高速IC只用于小功率小電流,而聯柵功率管則將多晶硅發射極應用于大功率大電流,獲得了高開關速度和高頻率。
聯柵晶閘管GATH在與IGBT相同的電流密度下,關斷速度更快,拖尾更小。如附圖2-13、2-14所示。1200V GATH可工作在20KHz。
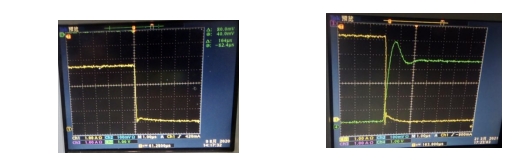
圖2-13 GATH(X方向 1uS/格) 圖2-14 IGBT(X方向 1uS/格)
在多晶硅發射極與硅襯底之間的界面上存在大量的高密度的復合中心,加速了載流子的復合,使聯柵功率管電流拖尾減小,關斷加快,從而獲得高頻。
2.5 聯柵功率管工藝2.5.1聯柵功率管工藝平臺

圖2-15聯柵功率管工藝平臺
2.5.2 聯柵功率管工藝流程

圖2-16 聯柵功率管工藝流程圖
2.5.3 4500V RCGATH器件的開發2.5.3.1目標
孵化項目在6吋線工藝基礎上,開發逆導型(集成二極管)RCGATH 4500V/150A芯片;封裝4500V/1800A焊接模塊,4500V RCGATH模塊測試試驗。
2.5.3.2內容
1、高抗沖與低損耗良好折衷特性RCGATH芯片技術、低反向恢復峰值電流與低正向壓降良好折衷特性的集成續流二極管芯片技術;自動均流的高芯片參數收斂性芯片技術研究;
2、4500V/1800A焊接型RCGATH器件
3、4500V/1800A焊接型RCGATH模塊測試試驗
2.5.3.3研發內容
課題1:高抗沖與低損耗良好折衷特性RCGATH芯片技術、低反向恢復峰值電流與低正向壓降良好折衷特性的集成續流二極管芯片技術;自動均流的高芯片參數收斂性芯片技術研究
主要研究內容:
(1)高抗沖與低損耗良好折衷性能的RCCATH芯片技術研究
芯片產出單管封裝后進行抗沖的極限考核與電流輸出特性的考察。抗沖的極限考核包括過電壓極限考核、短路極限考核與控制極限考核。過電壓極限考核即過電壓幅度與沖擊次數極限考核;短路極限考核即短路電流的大小與持續時間長短的極限考核;控制極限考核即能夠關斷的最大電流考核。
柵區匯流條越寬,帶寬越窄,則抗沖擊能力越強,而電流能力則越弱,即飽和壓降越高。反之亦然。要用實驗數據和曲線來確定二者的良好折衷,從而確定“帶寬/柵區匯流條”的版圖設計基本規則。
柵區越寬,發射區越窄,則抗沖擊能力越強,而電流能力越弱,即飽和壓降越高。反之亦然。要用實驗數據和曲線來確定二者的良好折衷,從而確定“發射區寬度/柵區寬度”的版圖設計基本規則。
(2)低反向恢復峰值電流與低正向壓降良好折衷的集成續流二極管芯片技術研究
A.設計2-4種不同陽極圖形(不同密度、不同P+/P比例)的版圖。
B.設計2種不同陰極圖形(不同密度、不同尺寸)的版圖。
通過芯片產出,封裝單管,測量反向恢復特性曲線和正向輸出特性曲線,確定同時兼顧低反向恢復峰值電流、反向恢復軟度好而且正向壓降低的版圖參數。
(3)自動均流程度和規律調查,芯片電參數收斂性0.1V
A.電流輸出特性曲線與驅動電壓的關系
B.電流輸出特性曲線與管溫的關系
C.電流輸出特性曲線與摻雜(兩種擴磷條件,兩種擴硼條件的關系)
通過A、B、C,摸清模塊內多管芯并聯的電流自動均流和多模塊并聯的電流自動均勻的程度和規律。做到在工作點附近,芯片的電參數收斂系數0.1V。
設計并制作焊接型4500V/150A RCGATH芯片,為4500V/1800A焊接型RCGATH模塊做準備。
預期目標:
實現高抗沖低損耗良好折衷,低反向恢復峰值電流與低正向壓降良好折衷,基本上能夠自動均流的高參數收斂性的RCGATH芯片。
考核指標:
(1)RCGATH芯片封裝單管后檢測,達到在雙倍額定電流下持續10mS(IGBT持續1mS), 短路時間100μS(IGBT 10μS)。
(2)VSDsat收斂性0.1V,芯片良率e 80%。
(3)發表三大檢索或核心期刊論文2篇,申請發明專利 2項。
課題2:4500V/1800A焊接型RCGATH器件
考核指標:
(1)4500V/1800A焊接型RCGATH器件設計方案1套;
(2)4500V/1800A RCGATH模塊電流3600A持續開通時間10mS后;能夠關斷(IGBT持續時間1mS);短路耐受時間100μS(IGBT 10μS)。PC 功率循環能力e 1 萬次(結溫差80K),溫度循環能力e 100 次(-40℃~125℃ ),溫度沖擊能力e 100 次(-40℃~125℃ )。
課題3:4500V/1800A焊接型RCGATH模塊測試試驗
主要研究內容:
(1)研究4500V/1800A焊接型RCGATH靜態特性、動態特性、安全工作區測試方案,搭建大電流測試平臺;
(2)研究適用4500V/1800A焊接器件的關鍵可靠性測試方法,完成器件級可靠性試驗評估;
預期目標:
具備 4500V/1800A焊接器件的靜、動態特性及可靠性測試能力,支撐課題 1、2 相關優化;提出4500V/1800A焊接器件的關鍵可靠性測試方式并評估產品可靠性。
2.5.4 6500V GATH設計2.5.4.1研制目標
表2-1 4500V GATH主要技術指標


本項目產品是6500V,600A的IGBT模塊,可靠性指標執行《半導體分立器件模塊通用規范》(報批稿)JM1級編制及考核控制要求,此項目主要從模塊套件和焊料選取方面進行設計,可靠性指標可以達到軍用分立器件詳細規范編制及考核控制要求。
2.5.4.2 電參數
表2-2 6500V GATH與IGBT電參數對比表
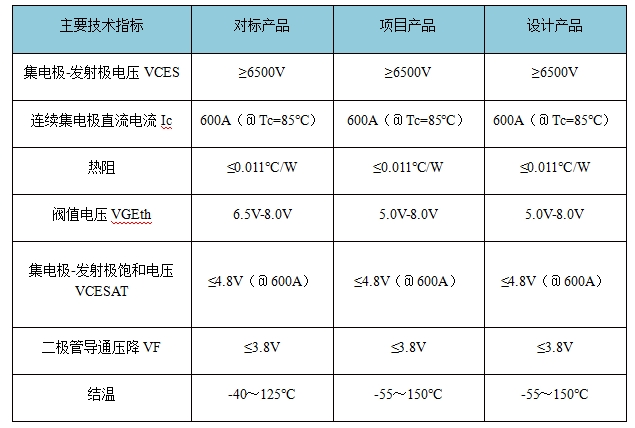
2.5.4.3產品研制方案2.5.4.3.1產品設計
參數設計
GATH芯片產品已經很成熟:有源區的設計已經定型;適用于各種耐壓規范和電流規范;終端結構也很成熟。
6500V 600A 產品只需要變更襯底電阻率厚度、終端寬度即可。參考公開資料,選取電阻率在550-700歐姆厘米。終端寬度取3000微米。終端形式為POLY-AL 雙場板+場限環。只需要撒網調整環間距、場板寬度。
表2-3 6500V GATH設計指標

2.5.4.3.2 技術分析與把握 2.5.4.3.2.1關鍵技術和技術難點分析
研制產品在6英寸線的最大管芯尺寸為14mm*15mm。必須在一個管芯內電流達到50A且耐壓達到6500V,電流越大越好。
研制產品的難點在于6500V耐壓和最大電流的折中。終端越寬,襯底越厚,耐壓越高,但是,最大電流越小。反之,終端越窄,襯底越薄,最大電流越大,耐壓越低。
6500V GATH做逆導型GATH。IGBT由于閂鎖天花板,高壓大電流芯片很難集成續流二極管。GATH無閂鎖,集成FRD可靠性更高,成本更低。
2.5.4.3.2.2技術難點及解決途徑
1 、擊穿電壓 6500V(由襯底電阻率和終端決定)
1) 襯底選擇
襯底電阻率參考 6500V IGBT/IGCT 電阻率 370---700歐姆厘米 達到7000V
GATH襯底電阻率 500-600歐姆厘米/襯底高阻層厚度 580微米---680微米/最終取 650微米
2)終端確定
A.采用雙場板+場限環 寬度 3000微米
B.備用 多區 JTE 終端
JTE 終端2000微米能夠達到6500V。JTE 對表面電荷十分敏感,穩定量產,取決于工藝線的控制水平。
2、FS層
GATH的FS層是在減薄之后通過注H形成
6500V 600A 的襯底厚,可以先做背面FS層先做背面工藝比較穩妥可靠。
3、逆導型
逆導型,集成二極管,沒有連線,更加可靠。
由于閂鎖,IGBT的高壓大功率產品不能做逆導型。逆導型,必定帶來橫向電場的不均勻,更容易發生閂鎖。因此,IGBT的逆導型,僅僅能夠用于低壓小功率的軟開關。
GATH無閂鎖問題,其抗毀損能力是IGBT的10倍。所以,能夠應用與高壓大功率硬開關。
總結:
終端為POLY-AL雙層場板+場限環,寬度為3000微米,對環的間距、場板寬窄做處理。通過撒網試驗,取最佳的耐壓與最大電流折中。
同時,做JTE終端試驗。JTE終端,能夠以最小的寬度達到最高的耐壓。但是,對表面很敏感,即對工藝的要求很高。JTE能夠用2000微米寬度做6500V
我們的終端水平是很高的。國外1700V產品,用場板+場限環,需要850微米。
我們只用650微米,做到2000V以上。
我們用450微米寬度的JTE,達到2200V的耐壓。
聲明:本內容為作者獨立觀點,不代表電源網。本網站原創內容,如需轉載,請注明出處;本網站轉載的內容(文章、圖片、視頻)等資料版權歸原作者所有。如我們采用了您不宜公開的文章或圖片,未能及時和您確認,避免給雙方造成不必要的經濟損失,請電郵聯系我們,以便迅速采取適當處理措施;歡迎投稿,郵箱∶editor@netbroad.com。
| 聯柵晶閘管GATH-應用場景與結論 | 25-03-20 10:05 |
|---|---|
| 聯柵晶閘管GATH-驅動特性與可靠性實驗 | 25-03-20 09:55 |
| 聯柵晶閘管GATH-電氣特性 | 25-03-20 09:42 |
| 聯柵晶閘管GATH-概述 | 25-03-14 11:50 |
| 一種新型IGCT——GATH | 21-03-05 14:00 |
| 微信關注 | ||
 |
| 技術專題 | 更多>> | |
 |
| 技術專題之EMC |
 |
| 技術專題之PCB |